AlGaN/GaN HEMT是下一代大功率電力電子器件的發展方向之一。然而在高壓大功率動態下工作時,AlGaN/GaN HEMT會出現動態特性比靜態特性變差的現象,即所謂的電流崩塌現象。場板結構是抑制電流崩塌、改善器件動態特性的常用方法。
中科院蘇州納米技術與納米仿生研究所納米加工平臺對高壓大功率AlGaN/GaN HEMT開展了系統的研究,在國際上首次提出并制備了新穎的雙柵HEMT器件。通過雙柵結構中的頂柵電極(Top-Gate)模擬分析了源場板和柵場板對器件動態特性的改善原理。研究成果發表在IEEE Electron Device Letters(vol.34, p.217, 2013)。在國際半導體產業界和學術界具有廣泛影響的雜志Semiconductor Today對此研究結果進行了報道。
在此基礎上,研究人員進一步提出了提高器件動態性能的工作模式:器件關態時頂柵加0V電壓,開態時頂柵加正電壓。并分析了此種工作模式下器件柵漏電極之間漂移區的動態導通電阻的分布情況。研究結果發表在IEEE Electron Device Letters(vol.34, p.747, 2013)。Semiconductor Today對此研究結果進行了報道。
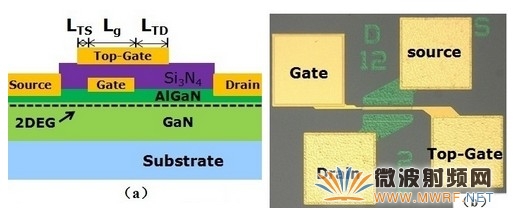
圖1、(a)雙柵HEMT 的剖視圖,(b)雙柵HEMT 的顯微鏡照片
雙柵AlGaN/GaN HEMT器件的獨特之處在于:具有一個通過介質層與柵電極隔離,覆蓋于柵電極上方的可以單獨加電壓信號控制的頂柵電極,頂柵電極向源端和漏端各有一定長度的延伸(見圖1)。
器件關態時,頂柵加0V電壓,此時的頂柵起到場板的作用,可以降低柵漏電極之間的峰值場強,改進器件的動態特性。器件開態時,頂柵加正電壓能夠在溝道中感生出額外的電子,感生的電子可以在一定程度上增加2DEG的面密度,從而改進動態特性。基于以上原理,提出了文章中的雙柵AlGaN/GaN HEMT器件的工作模式,頂柵在器件關態時加0V電壓,在器件開態時加正電壓。
圖2所示為此工作模式的輸入和輸出電壓波形,從圖中可以看出隨著器件開態時頂柵電極所加正電壓的增加,器件的開啟延遲時間和動態導通電阻逐漸降低。

圖2、雙柵器件輸入信號和輸出信號波形圖
所測結果如表1所示,與源場板結構相比(開態時頂柵電極加0V電壓),開態時頂柵電極加+30V電壓,器件的開態延遲時間和動態導通電阻分別降低55%和17%。基于此種工作模式,研究人員從空間上分析了柵電極和漏電極之間漂移區電流崩塌對器件動態特性的影響。研究發現,靠近柵端的電流崩塌對器件的開啟時間影響較大,靠近漏端的電流崩塌對器件的動態導通電阻影響較大。
表1、開啟延遲時間(τfd)和動態導通電阻(Ron_D)與關態頂柵電壓的關系(VTG_on_state)

 粵公網安備 44030902003195號
粵公網安備 44030902003195號